
薄膜测量
1.薄膜测量
薄膜是沉积在另一种物质表面的非常薄的物质层,广泛应用于技术工艺行业,如钝化绝缘层、防扩散层、硬涂层等。集成电路就主要由薄膜的沉积和选择性的去除组成。
物理厚度作为薄膜最基本的参数之一,对整个器件的最终性能具有重要影响。因此,快速而精确地测量薄膜厚度具有重要的实际意义。
2.薄膜测量原理
由于光学测量方法准确,无破坏,只需很少或无需专门样品,光学测量法常常是薄膜测量的首选方法。传统的测量薄膜物理厚度的光学方法主要有光度法和椭偏法两种。椭偏仪测量具有灵敏度高的优点,但是受界面层等因素的影响,需要复杂的数学模型来求解厚度,上述方法已经成功而广泛地应用在各个领域。然而,近年来微光机电系统等微加工技术的发展,经常需要在高低起伏的基板上(patterned substrate)沉积薄膜,因此用测量表面轮廓的白光干涉仪来进行薄膜厚度测试的方法引起了人们的关注。
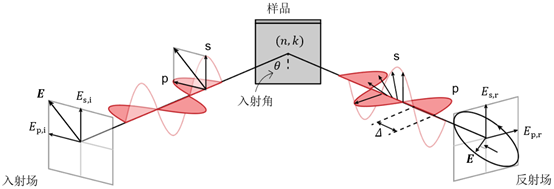

椭圆偏振仪的基本原理
光学测量是通过精确测量薄膜与光线的相互作用来获取薄膜特性的技术。这些特性包括薄膜的厚度、表面粗糙度以及光学常数等。通过光学测量,我们可以将这些光学常数与其他材料参数(如成分和带隙)相关联。光学常数(n和k)描述光如何通过薄膜传播。在某个时间光穿过一种物质的电磁场可以简单表示为

其中x:距离,λ:光波长,n和k:薄膜相应的折射率和消光系数。折射率是光在物质和真空中传播速度的比值。消光系数是测量光在物质中被吸收了多少。
3.光纤光谱仪实现薄膜厚度测量
当入射光穿透不同物质的界面时将会有部分的光被反射,由于光的波动性导致从多个界面的反射光彼此干涉,这两部分反射光可能干涉相长(强度相加)或干涉相消(强度相减),这取决于它们的相位关系。而相位关系取决于这两部分反射光的光程差,光程差又是由薄膜厚度、光学常数和光波长决定的。

薄膜厚度测量原理示意图
薄膜测量系统是基于白光干涉的原理来确定光学薄膜的厚度。白光干涉图样通过数学函数的计算得出薄膜厚度。对于单层膜来说,如果已知薄膜介质的n和k值就可以计算出它的物理厚度。
如下图为光镀有折射率为η膜层折射率为n1的基板光路示意图。使用光纤光谱仪测量薄膜的厚度主要是通过反射光谱,反射光谱曲线中干涉峰的出现是薄膜干涉的结果。

光镀有折射率为η膜层折射率为n1的基板光路示意图
4.实验
4.1实验目的
测量太阳能板样品400-1100nm的薄膜厚度光谱测量。
采用莱森光学LiSpec-HS400高灵敏光谱仪,采用典型积分球反射光路,实现客户测试要求。
一共三个样品,测量三个样品的薄膜厚度,测量每个样品两层膜的厚度,测量膜系结构是硅基底上镀了一层厚度为1-2nm的氧化硅,再上面是poly-si膜层,膜厚在100nm左右。


图1 样品图片
2.2实验仪器列表
仪器/设备名称 | 型号&序列号 | 配置明细 |
高灵敏光谱仪 | LiSpec-HS400 | 光谱范围:200nm-1100nm |
大功率卤素灯光源 | iLight-HAL-HP | 输出功率100W,强度可调,SMA接口 |
积分球 | iSphere-C3-REF | 1、光谱范围:200-2500nm 2、出光口均匀性:>99% 3、积分球材料反射率:≥98% |
光纤 | IFB-600-1-GS | 光纤芯径:600微米 光纤长度:1米 |
2.3实验内容
薄膜厚度设备测量示意图:

光路实验示意图

光路实验实物图
2.4实验结果
以下计算薄膜的算法使用的是光谱白光干涉,拟合使用L-M拟合和PS优化结合使用。计算结果如下表格:
2.4.1 3号样品

膜层 | 材料 | 拟合厚度 |
Layer1 | Poly-si | 140.638 |
Layer2 | SiO2 | 4.51338 |
2.4.2 4号样品

膜层 | 材料 | 拟合厚度 |
Layer1 | Poly-si | 140.167 |
Layer2 | SiO2 | 4.46099 |
2.4.3 5号样品

膜层 | 材料 | 拟合厚度 |
Layer1 | Poly-si | 140.209 |
Layer2 | SiO2 | 4.49997 |
3.结论
通过数据得出测量Poly-si的厚度为140nm±1nm,SiO2的厚度为4nm±1nm。