
硅膜厚度测量
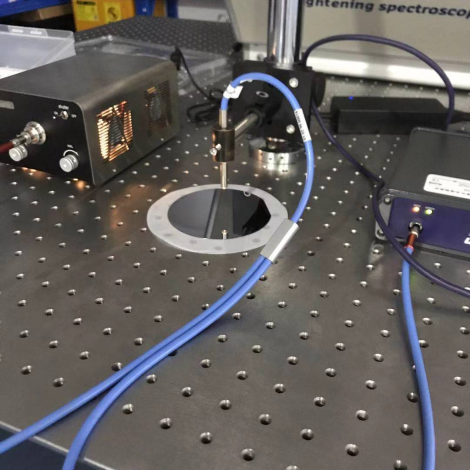
实验光路图
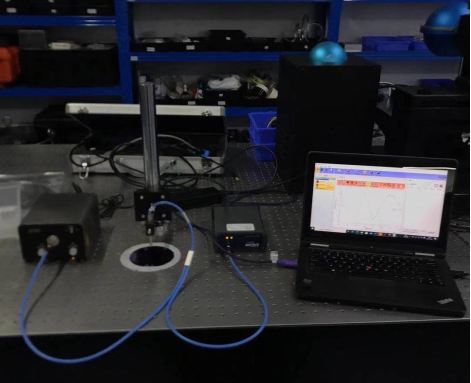
实物光路连接图
实验背景目的:
各种介质、半导体和金属的薄膜在电子工业、光学工业和化学工业等得到了广泛的使用。膜层的厚度对器件或仪器的性能有直接影响。如硅徽型电路的介质层的厚度和成分,对半导体工业具有很大的重要性,这些膜层的厚度将决定集成电路器件的性能和可靠性。莱森光学可提供膜厚测量服务,通过无损的光学测量方法,基于白光干涉原理,使用光纤光谱仪实现膜厚测量,以比传统的方法更精度更高,测量速度更快地测量出硅片的膜厚。
实验结果:
实验使用单晶硅作为白参考,所以以下的实验数据都是考虑了单晶硅的反射率的。以下计算薄膜的算法使用的是光谱白光干涉,拟合使用L-M拟合和PS优化结合使用。计算结果如下表格:
样品名字/位置 | 厚度/nm |
样品1-1 | 600.021 |
样品1-2 | 601.498 |
样品1-3 | 604.675 |
样品1-4 | 601.737 |
样品1-5 | 596.645 |
样品2-1 | 417.323 |
样品2-2 | 417.001 |
样品2-3 | 419.159 |
样品2-4 | 418.875 |
样品2-5 | 418.504 |
样品3-1 | 510.566 |
样品3-2 | 575.974 |
样品3-3 | 579.537 |
样品3-4 | 445.861 |
样品3-5 | 440.772 |
样品1-1

样品1-2

样品1-3

样品1-4

样品1-5

样品2-1

样品2-2

样品2-3

样品2-4

样品2-5

样品3-1

样品3-2

样品3-3

样品3-4

样品3-5

实验结论:
编号 | 平均膜厚(nm) | 标准偏差值 |
1 | 601.98275 | 2.9234102% |
2 | 418.1724 | 0.957946136% |
3 | 510.542 | 67.25537504% |